
首頁
關于我們
關于我們

企業簡介
企業榮譽
全球布局
新聞中心
企業社會責任
社會責任政策和制度
沖突礦產管理
質量環境管理
質量方針
體系認證
環境管理方針
服務內容
服務內容
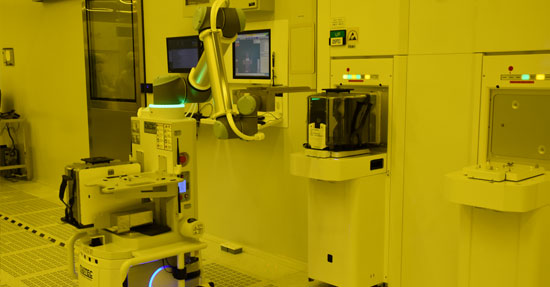
中段凸塊
晶圓測試
晶圓級芯片封裝
創新研發
供應商管理
供應商管理
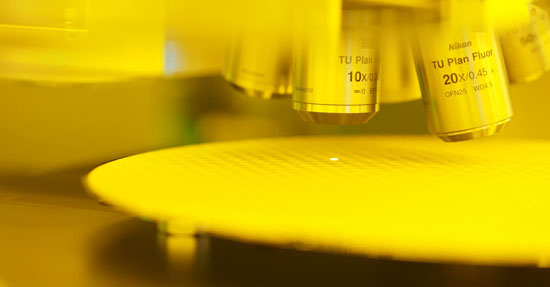
聯系采購
加入我們
加入我們

招聘崗位
人才發展
聯系我們
EN
EN